过去两年,我们对Intel(英特尔)这家公司的技术和市场报道得相当频繁。主要也是因为PC与数据中心市场这两年来的多变,加上半导体行业从去年下半年开始步入下行期,以及Intel在外部压力下面临的市场挑战。
上周在北京举办的2023年英特尔中国战略媒体沟通会,尤其是宋继强有关Intel技术路线的演讲部分,更像是我们这一年来技术报道的全面总结。而有所不同的是,我们也从王锐和其他高层的发言中,了解到了Intel在中国的战略布局,并以此推及Intel全球市场。
像这样的沟通会,不仅是提纲挈领式地总结Intel在行业内所处的位置和未来发展规划;基于Intel作为目前少数一家还在做半导体尖端制造工艺的IDM企业,也是了解半导体行业动向的途径。借着这篇文章,我们来谈谈Intel和行业的未来;顺带也将给出此前相关Intel技术的文章索引,供各位技术爱好者参考。
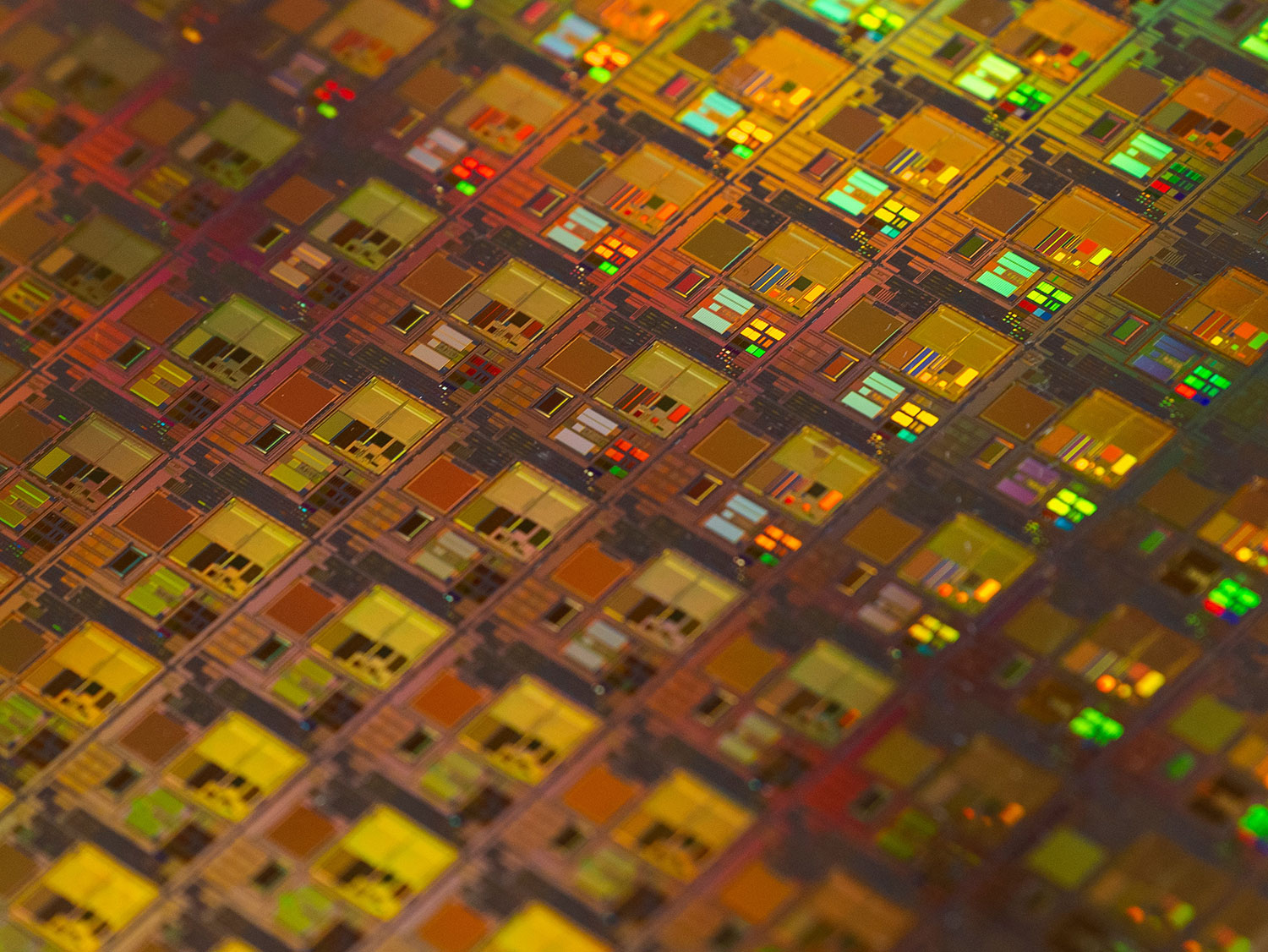
过去两年在Intel的半导体制造,于尖端工艺上首度表现出颓势,PC与数据中心处理器市场开始流失之际,Intel换帅及IDM 2.0计划应当是半导体行业内的大事件了。简单来说IDM 2.0主要包括(1)坚持IDM模式不动摇,继续先进制造工艺节点研发;(2)Intel部分芯片设计可由其他foundry厂制造——比如前不久我们才体验过的Arc GPU就是由台积电造的;(3)fab厂更积极地对外提供foundry服务,名为IFS,也包括非常先进制造工艺。
这对Intel而言是非常积极的战略转变。但像IDM 2.0这种长期转型计划,很难在短期内就产生效果。这两季Intel财报数字并不怎么积极而招致外界质疑。而实际上Pat Gelsinger宣布IDM 2.0战略也就是2021年3月份的事。其实从一个工艺节点的生命周期就知道,规划中公布的新节点启动时间甚至应该早于Gelsinger上任。
英特尔公司高级副总裁、英特尔中国区董事长王锐在主题演讲中说:“最近福布斯有篇文章讲述了这样一个观点:像Intel这样的大型半导体公司转型,或者说其实任何大公司的转型都要经过4-5年。所以我们不能以‘一时一事’来衡量像Intel这样的公司。”

Intel当前面临的逆风盘还真是相当有难度,包括地缘政治、市场下行期、行业竞争加剧、供应链面临挑战这些外部不利因素;内部有半导体尖端制造工艺更新难度与成本骤增、IDM 2.0转型、产品推进等各方面的压力。“转型的阵痛很难避免,特别是我们这样一个涉及面如此之广的公司。但关键是我们有没有能力、能不能执行到位。”王锐说。
单就大环境,“毫无疑问,半导体行业进入了新的调整期。但是我们认为,短期的调整并不影响这个行业长期向好的趋势。”王锐回顾了本世纪经历过的前两次周期性调整,分别在互联网泡沫出现,以及2008年金融危机之时;她也特别谈到了“每次疾速下滑之后,随之而来的是相对快速的回升”。
投资布局未来,应该是现在主要半导体企业在逆风局下的一致打法了;即便实际上我们看到了成本收紧带来的一系列企业动作。而在我们看来,保持IDM这种重资产模式的Intel,未来重回王座的依托仍然是技术。
对摩尔定律的唱衰和各类说法已经被谈得够多了。我们总结摩尔定律的未来发展,技术依托无外乎(1)器件层面 a.器件间距微缩pitch scaling;b.器件结构变革,如GAAFET,或者更遥远的CFET(2)封装层面,2.5D/3D先进封装;(3)材料层面革新,比如2D材料在FET中的应用;(4)其他微缩技术…
器件层面的间距微缩,也就是我们常说的半导体制造工艺节点迈进,这是传统意义上摩尔定律实现的基础。Gelsinger此前在多个活动中都提到过,预计在IDM 2.0战略的指引下,Intel计划于2025年重新取得名列前茅地位。

Intel在此之前就公布了要在4年内推进5个工艺节点的计划。英特尔研究院副总裁、英特尔中国研究院院长宋继强重申了这一计划,包括已经量产的Intel 7,以及接下来的Intel 4、3、20A、18A。从PPT来看,Intel的这几代节点工艺推进算是基本顺利,尤其Intel 20A、18A都已经完成了测试芯片的流片。
有关Intel的半导体尖端制造工艺技术推进,我们写过多篇文章做技术剖析,建议阅读:
实则从这4年的工艺节点更新规划来看,Intel的节点更新步伐和10nm时代之前已经大不一样,主要体现在器件微缩幅度在节点间变小;而且采用模块化的技术更新思路,以及TICK-TOCK更新策略、加入半代节点作为缓冲,都有助于降低工艺迭代可能失败或无法如期交付的风险。
如果2025年Intel 18A能如期上马,那么重新拿回制造工艺方面的名列前茅地位是可行的。不过我们也知道,foundry厂放卫星是常规事件,台积电和三星也都不是头一回放卫星了。这也体现出尖端制造工艺的技术难度和不确定性。现阶段,我们非常期望看到Meteor Lake在Intel 4工艺上的成熟度表现。
宋继强再度谈到了Intel 4、3要开始应用EUV极紫外光刻,到20A节点率先采用高数值孔径的EUV光刻机;以及20A节点上,器件结构从FinFET过渡到RibbonFET,也就是GAAFET;还有PowerVia技术,也就是backside power delivery网络,将供电电路放到晶体管后方的技术…这些我们在上述文章里都有详细的解释。

而在封装层面,也就是很多人常说的more than Moore – 先进封装是我们近两年报道的大热门。Intel的EMIB硅桥式2.5D封装方案,以及3D封装的Foveros技术也是我们谈先进封装的常客。这部分的技术讲解,建议阅读以下文章:
现阶段就尖端封装技术上,我们更加关心的是3D封装的Foveros迭代进度:尤其第三代Foveros Omni的双向互联和第四代Foveros Direct。其中“Foveros Omni可以提高灵活性,将上方大芯片和底下各个小芯片之间,通过在各个方向比较粗的铜柱,避免只在一侧供电的缺点。在小芯片的摆放上更为灵活,提升了供电效率”。
我们特别就Intel的第四代Foveros Direct技术进展——也就是采用Cu-Cu直接互联的hybrid bonding混合键合方案——做了提问。因为hybrid bonding未来极有可能成为先进封装工艺技术争夺的热点,即便现阶段受限于技术复杂度和成本,还未大规模应用。台积电在这方面也摩拳擦掌。
宋继强表示:“这个技术Intel做了很多很先进的研究。至于说在什么样的产品里实现,就要看各个产品的需求是不是需要去做。因为毕竟这项技术还是比较贵的。这方面,Intel在IEDM 2021、2022都做了混合键合研究前沿的介绍。从我们2022年公布的数据来看,Intel的混合键合已经可以做到3μm的间距,这是目前较好的结果。”
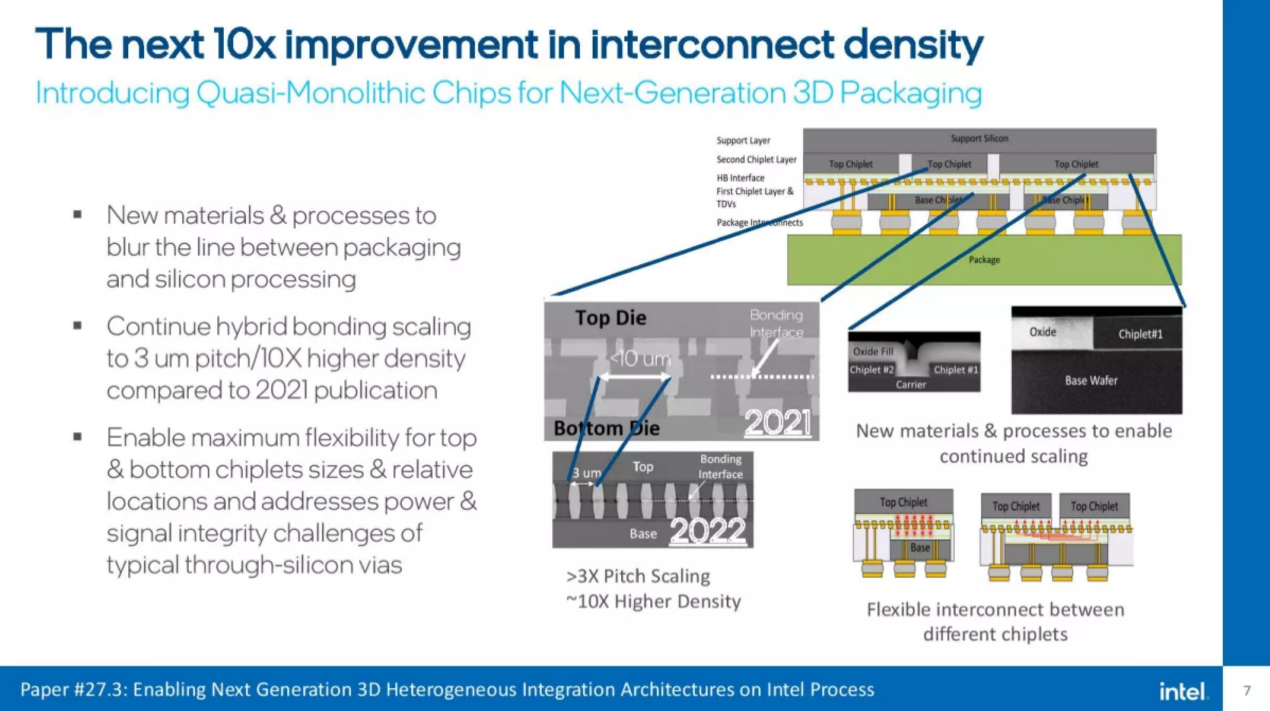
去年的IEDM 2022上,在3D封装技术方面,Intel谈到一种名为QMC(Quasi-Monolithic Chips,准单片)的封装方案。QMC这个名字的意思,是Intel期望未来即便采用多chiplet,性能和功耗也可与monolithic单die方案几乎等同。
QMC也是一种hybrid bonding技术。Intel当时给的数据是键合间距<3μm,能效和性能密度提升约10倍。3μm这个值是比Foveros Direct互联间距10μm还要低很多的。虽然我们不知道这个技术具体什么时候走出实验室。
这次采访中,宋继强说对于QMC这个级别的技术而言,“不仅要用混合键合,还要考虑其他技术。比如说传统意义上的封装厂,它的基板(substrate)大多还含有有机材料。但做先进封装的时候,很多时候温度环境有机材料不一定受得了。要真正把先进封装和晶圆制造的界限模糊掉,必须把基板材料全部替换成无机材料,这个Intel正在做。”
这也是我们现在说先进封装在广义的半导体制造流程中,处于“中道(mid-end)”而非传统封装中的“后道”的某种表现。“这一步也很关键,可以保证未来整个流程的糅合,而不是说在做晶圆的时候要做很多预处理,到封装厂的时候又必须再重复做一次,两边衔接起来还是会有问题。”
“另外我们还发现在做硅过孔(TSV)的时候,硅过孔还是存在局限性。不管是IR-drop(电压降),还是其他比如电流信号完整性上都有局限性。Intel既然已经采用了无机材料做了很多填充,现在也正在通过绝缘的介质层做过孔。”宋继强说,“这种过孔可以更好地去提高电流信号的完整性,增加IR-drop层面的性能。”
他还提到了这类3D封装需要考虑的其他技术挑战,“不只是铜键合的问题”。未来电子工程专辑还会就hybrid bonding技术单独撰文。宋继强补充说:“相信Intel在先进封装方面是拥有较全技术堆栈的公司,我们有信心在这方面做到名列前茅。”

随同QMC封装技术一起,IEDM 2022上Intel重点谈到的还有几项技术,包括2D材料——即3个原子厚度的材料,可以应用到GAAFET晶体管上;以及3D堆叠的FeRAM;某种“不会遗忘”或者说断电时不会丢失数据的晶体管;功率器件方面,硅基叠加氮化镓实现更好的性能,可应用于电动汽车、5G/6G等领域……这些我们在下面这篇文章里有详细介绍:
所以基于器件、封装以及系统方面的方案,Intel之前就说愿景是在2030年在单设备(单个封装)内达成1万亿晶体管数量,自然就实现了摩尔定律的延续。“摩尔定律到现在又有了新的发展方式,就是通过晶圆制造、先进封装、芯粒(chiplet)可以延续摩尔定律单位面积晶体管倍增的增长曲线。”
值得一提的是,一旦涉及到不同chiplet的分拆,以及异构集成或者存储与逻辑电路分开之类的方案,那么标准、生态就很关键了。毕竟不同的chiplet供应商得使用相同的“接口”或者“介面”做到互联互通,chiplet和异构集成才有持续高速发展的可行性。
所以Intel在宣传中自然也就提到了正在热推、面向chiplet的物理层UCIe标准;以及做设计、验证、优化的软件工具,包括Intel的oneAPI,“帮助统一未来异构计算上下层的硬件的编程,底层不同硬件的对接,很好的性能库”,和一些专门的工具包。

IDM 2.0之中的IFS“系统级代工”服务,即是上述包括制造、封装、chiplet,以及软件在内的各种能力的总和。也就是把所有这些技术,通过foundry服务对外提供。这里面宋继强特别提到了“系统工艺协同优化”的芯片设计概念,可能是未来大芯片设计的发展方向。他说:
“系统工艺协同优化其实是一种由外向内的发展模式。也就是说,未来当我们定义一个芯片产品时,首先要了解这个芯片要怎么用,从它的使用功能拆解,用哪些架构、不同的XPU去实现它;然后又选择哪些工艺节点将其构造起来、生产出来。整个过程可以从上层的应用分析、软件工具到底层的封装、制造,联合优化各个环节,持续推进芯片创新。”大意就是说从应用出发的芯片设计,这其实也是近两年EDA/IP厂商普遍在宣传的。

从大方向来总结,Intel的产品策略主体仍然是XPU——也就是各种类型的处理器硬件,外加oneAPI这个抽象中间框架,以及当前符合时代大潮的chiplet、先进封装、异构集成,以及其上的UCIe标准。这也是时代主旋律。
我们在2023新年技术展望中提到过,对于数据中心服务器而言,至2030年之前,包括GPU、NPU、FPGA等各类加速器会吃掉CPU通用处理器的大量市场价值,甚至彻底颠覆CPU的价值主导地位。这应该是Intel过去一直在积极部署上述路线的根本,甚至此前探索RISC-V在HPC市场的可行性大约也有这样的成分。
这也符合低碳、节能的时代主旋律,所以宋继强甚至在谈到ChatGPT时都说这类AI模型未来对算力需求的大幅提升,需要有可接受的功耗和效率表现,“要不然就达不到绿色计算的目的”。“绿色计算”还真是整场活动不同发言人反复在提的词组,虽然我们认为它表达的核心也就是专用计算、异构集成带来的效率提升,以及对摩尔定律停滞不前的缓解。
上面这些对于关注Intel的同学而言,应该都属于常规信息更新。当然还有一些内容受限于篇幅没有去谈,比如说XPU策略上持续推动SNN也就是类脑芯片或者说神经拟态芯片的发展——此前Intel基于Loihi 2打造了整合768块该芯片的板极方案,以及神经拟态计算的生态发展情况等等。(有关Loihi神经拟态计算芯片,建议看这篇文章:• 摩尔定律死了,AI芯片算力提升靠谁?)
这次媒体沟通会的另一个主题就是Intel的中国战略更新。包括王锐提到的Intel China 2.0英特尔中国2.0,以及本次特别宣布的成立英特尔中国开源技术委员会——这也是英特尔中国2.0的组成部分。后者主要是Intel在软件方面的动作,本文不会做过多涉及。

即便有地缘政治这种很难摆脱的外部阻力在,中国市场对Intel而言都是不容忽视的。王锐在本场会议的开篇就提到了“中国数字经济发展速度令人瞩目”,2023年中国数字经济规模会达到52亿元,未来10年还会翻番。
“我们CEO经常提到英特尔中国对整个公司来说至关重要。”王锐说,“一年多以前,我们提出了英特尔中国的战略升级,也就是从Intel China 1.0时代转到Intel China 2.0时代。”
“具体来说,就是更好地整合全球资源支持本地运营,更加针对本土驱动的创新展开更深入合作,为中国的产业伙伴提供更有利的支持。也就是说,我们秉持植根中国、服务中国的理念,推动共同发展。”
Intel在新闻稿中说这是“首次系统阐述英特尔中国2.0”。从王锐的总结来看,当前Intel的中国战略发力点包括有:
另外还有教育相关的本土人才培养、社会公益事业、回馈社会惠民服务等等。对此感兴趣的同学可以去看一看Intel官方的介绍,这里不做深入。
这部分最后值得一提的是,作为中国2.0战略构成的一环,这次媒体沟通会上英特尔公司副总裁、英特尔中国区软件生态部总经理李映特别将“软件”作为一个章节做了着重阐释。
这部分虽然并非我们要关注的重点,但在活动上,李映谈到了Intel在软件方面尝试“融合中国生态”的发展动向,比如与百度飞桨PaddlePaddle合作,Intel本土团队打造车载虚拟化技术等。另外更重要的是,李映在会上正式宣布了英特尔中国开源技术委员会的成立。

李映在媒体采访环节说,Pat Gelsinger“回来之前是一家软件公司的CEO”,“他带回来一个很大的改变-软件优先、拥抱开源。我们今天看到Intel的很多投入和技术方向也跟这个大方向一致”。
我们认为,Intel在包括GPU在内的加速器市场要取得形似CPU市场那般地位,软件与开发生态自然是关键与核心。要不英伟达也不会整天说自己其实不是个芯片公司了;CUDA及其生态,乃至英伟达在AI领域的市场可不是大风刮来的。在软件上拥抱开源对现如今的Intel而言是个不错的选择。
其实有关这个开源技术委员会究竟要做些什么,Intel好似并未做明确表达——李映回顾了一下目前Intel有19000个软件工程师、开源项目100+、开源投入也20多年;然后说了要“开放生态,拥抱开源、拥抱社区”,实现未来创新。
而针对中国一事,用李映的话来说,“中国开源社区的发展某个角度来讲是名列前茅全球的,或者相比全球趋势发展更快”;而且“中国开源社区有自己的特点”,“很多科技公司不仅把开源作为内部创新的源泉,更多是通过开源来引导整个生态、引导社区向前发展”。
李映相对笼统地谈到了委员会的主旨:(1)“打造自己的内功”,“把我们在中国的能力整合起来,为英特尔中国本土的创新和开源做出贡献”;(2)“作为一个平台,能够和合作伙伴进行更有效、紧密的结合”;(3)产生对公司、社会的效益,比如“发掘最新基于软硬件结合的业务模式”,这方面“需要做一些探讨”最终“推动未来创新”。
感觉说得还是挺泛的,或许可以等一等看未来该委员会的新动向,以及看一看它在异构计算时代,能给Intel带来多大的收益,即便Intel在反复强调“做开源这个事情并不是商业驱动的”。

从整场沟通会及其后的采访来看,我们认为虽然其间元素众多,比如绿色计算、可持续发展、中国开源技术委员会成立、摩尔定律延续、中国市场的合作列举、IDM 2.0战略回顾、包括chiplet/先进封装/晶圆制造在内的技术能力、未来材料技术展望、2025重回技术领导地位等……
其内核都是在讲述半导体产业正全面走向后摩尔时代:社会数字化转型大浪潮之下,仍有大量市场机遇,尤其企业和个人都对算力有着更迫切的需求;而解决算力提升(包括能耗提升)与需求不对等的问题时,面向不同场景的专用计算、异构集成变得愈发重要;上述种种都将成为Intel在新格局下完成转型、加强竞争力的关键组成部分。
文章来自:https://www.eet-china.com/




























